扇出型面板級封裝技術,護國神山裡的一片新森林
半導體產業鏈是台灣的護國神山,在這個產業內的上下游公司相互搭配合作,構築起一道峰峰相連的電子山脈,從IC設計、製造到封裝,有為數不少的重要關鍵技術配合,才使得台灣的半導體產業如此耀眼。
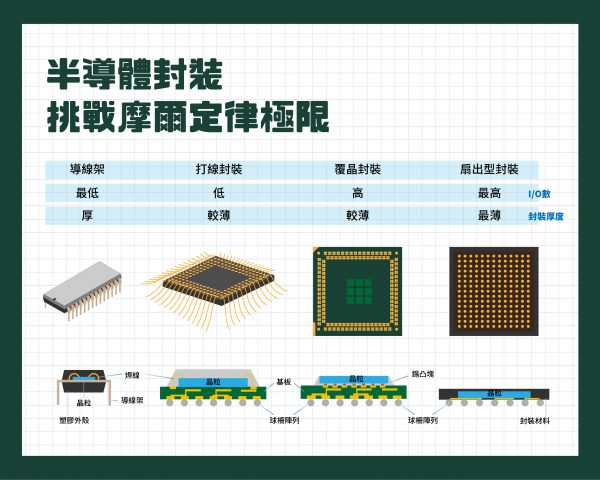
電子設備領域有一個非常基本的發展軌跡稱為摩爾定律,有大半個世紀的時間,IC產業都走在這條由高登·摩爾(Gordon Earle Moore)所預測的道路上:積體電路上可容納的電晶體數目,約每隔兩年便會增加一倍。然而,在經過五十多年的幾何級數成長之後,專家認為摩爾定律終將面臨難以突破的物理極限,半導體產業不會再以如此慣性發展。產業界也不斷研發尋找解方,推出各種先進製程,試著繼續推進電子元件提高效能。 時至今日,半導體製程越來越先進,當前段製程下探7 奈米,甚至2 奈米,後段載板的配線精密度也需要跟著提升。

因此業界研發出相稱的IC封裝技術–整合扇出型封裝,使得IC效能得以發揮,不會受限於封裝技術。目前扇出型封裝以「晶圓級扇出型封裝」為主,但因使用之晶圓設備尺寸限制導致製程基板面積受限,因此擴大製程基板的使用面積以降低成本,顯得相對重要。
為了推動國內半導體產業鏈更全面性的發展,經濟部技術處以科技專案支持工研院研發,以扇出型封裝為基礎,進一步發展出「扇出型面板級封裝技術」,使用此技術進行封裝的IC,不論是在體積與效能,相較於過往的封裝技術皆有大幅提昇,僅次於扇出型晶圓級封裝。更驚人的是,由於此項技術是以過去的面板生產線轉換而來,有效利用了閒置的產能,降低生產成本。

以面板產線進行IC封裝,得利於其方形面積,相較於晶圓的圓形有更高的利用率,達到95%。同樣因為面板生產線的特性,工研院與群創光電更投入在減少面板翹曲量,讓封裝製程的破片與耗損更低。而透過此一技術所完成封裝的電路線寬,可達到2mm ~ 10mm水準,僅次於扇出型晶圓級封裝。
在此項技術中,工研院整合了材料廠商、製造設備商與檢測設備商,研究出低應力的介電材料,高均勻品質的電鍍設備等等,有效提高技術改良價值,設計出第一條生產線。

除了原本單純的封裝技術,扇出型面板級封裝也整合了IC封裝的最新異質整合趨勢,額外整合具有5G通訊濾波功能的電路設計,使得封裝完的IC,更適合應用在5G通訊、物聯網設備等各種產品,有助於各種微小化消費性電子產品體積。不論是最基本的手機電腦、電動車、智慧機器人,都需要大量使用,這些晶片讓現代生活更智慧、更豐富。